01
Introducere
Taierea plachetelor este o parte importantă a producției de dispozitive semiconductoare. Metoda de tăiere cuburi și calitatea afectează direct grosimea, rugozitatea, dimensiunile și costurile de producție ale plachetei și au un impact semnificativ asupra fabricării dispozitivului. Carbura de siliciu, ca material semiconductor de a treia-generație, este un material important care conduce revoluția electrică. Costul de producție al carburii de siliciu cristalin-de înaltă calitate este extrem de ridicat și, în general, oamenii speră să taie un lingot mare de carbură de siliciu în cât mai multe substraturi subțiri de carbură de siliciu. În același timp, creșterea industriei a dus la dimensiuni progresiv mai mari ale plachetelor, ceea ce a crescut cerințele pentru procesele de tăiere cubulețe. Cu toate acestea, carbura de siliciu este extrem de dura, cu o duritate Mohs de 9,5, a doua numai după diamant (10) și este, de asemenea, fragilă, ceea ce face dificilă tăierea. În prezent, metodele industriale folosesc, în general, tăierea cu sârmă cu șlam sau tăierea cu sârmă diamantată. În timpul tăierii, ferăstraie fixe cu sârmă la distanță egală sunt plasate în jurul lingoului de carbură de siliciu, iar lingoul este tăiat cu fierăstrău cu sârmă întinsă. Folosind metoda ferăstrăului cu sârmă, separarea napolitanelor dintr-un lingot cu diametrul de 6 inci durează aproximativ 100 de ore. Napolitanele rezultate au tăieturi relativ largi, suprafețe mai aspre și pierderi de material de până la 46%. Acest lucru crește costul utilizării materialelor cu carbură de siliciu și limitează dezvoltarea acestora în industria semiconductoarelor, evidențiind nevoia urgentă de cercetare a noilor tehnologii de tăiere a plachetelor cu carbură de siliciu.
În ultimii ani, utilizarea tehnologiei de tăiere cu laser a devenit din ce în ce mai populară în fabricarea materialelor semiconductoare. Această metodă funcționează prin utilizarea unui fascicul laser focalizat pentru a modifica suprafața sau interiorul materialului, separându-l astfel. Fiind un proces fără-contact, evită uzura sculei și stresul mecanic. Prin urmare, îmbunătățește foarte mult rugozitatea și precizia suprafeței plachetei, elimină necesitatea proceselor de lustruire ulterioare, reduce pierderile de material, reduce costurile și minimizează poluarea mediului cauzată de șlefuirea și lustruirea tradiționale. Tehnologia de tăiere cu laser a fost aplicată de mult timp la tăierea cubulețelor de lingouri de siliciu, dar aplicarea sa în domeniul carburii de siliciu este încă imatură. În prezent, există mai multe tehnici principale.
02
Tăiere cu laser-ghidată cu apă
Tehnologia laser-ghidată cu apă (Laser MicroJet, LMJ), cunoscută și ca tehnologie laser micro-jet, funcționează pe principiul focalizării unui fascicul laser pe o duză în timp ce trece printr-o cameră de apă-modulată cu presiune. Un jet de apă cu presiune joasă-este ejectat din duză și, datorită diferenței de indice de refracție la interfața cu apă-aer, se formează un ghid de undă luminoasă, permițând laserului să se propage de-a lungul direcției fluxului de apă. Acest lucru ghidează un jet de apă-înaltă presiune pentru a procesa și a tăia suprafața materialului. Principalul avantaj al tăierii cu laser-ghidate cu apă constă în calitatea tăierii. Fluxul de apă nu numai că răcește zona de tăiere, reducând deformarea termică și deteriorarea termică a materialului, dar îndepărtează și resturile de prelucrare. În comparație cu tăierea ferăstrăului cu sârmă, este semnificativ mai rapidă. Cu toate acestea, deoarece apa absoarbe diferite lungimi de undă laser în grade diferite, lungimea de undă laser este limitată, în primul rând la 1064 nm, 532 nm și 355 nm.
În 1993, omul de știință elvețian Beruold Richerzhagen a propus pentru prima dată această tehnologie. El a fondat Synova, o companie dedicată cercetării, dezvoltării și comercializării tehnologiei laser-ghidate cu apă, care este în fruntea internațională. Tehnologia internă este relativ în urmă, dar companii precum Innolight și Shengguang Silicon Research o dezvoltă activ.
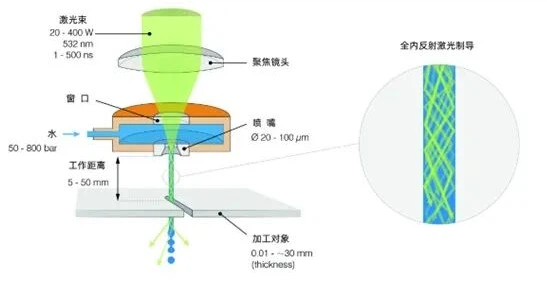
03
Stealth Dicing
Stealth Dicing (SD) este o tehnică prin care un laser este focalizat în interiorul unei plachete cu carbură de siliciu prin suprafața sa pentru a forma un strat modificat la adâncimea dorită, permițând separarea plachetelor. Deoarece nu există tăieturi pe suprafața plachetei, se poate obține o precizie mai mare de prelucrare. Procesul SD cu lasere cu impulsuri în nanosecunde a fost deja utilizat industrial pentru separarea plachetelor de siliciu. Cu toate acestea, în timpul procesării SD a carburii de siliciu indusă de laserele cu impuls de nanosecunde, durata impulsului este mult mai mare decât timpul de cuplare dintre electroni și fononi în carbură de siliciu (pe scara picosecunde), rezultând efecte termice. Aportul termic ridicat pe plachetă nu numai că face ca separarea să fie predispusă la devierea de la direcția dorită, dar generează și stres rezidual semnificativ, ceea ce duce la fracturi și clivaj slab. Prin urmare, atunci când se prelucrează carbura de siliciu, procesul SD utilizează de obicei lasere cu impulsuri ultrascurte, ceea ce reduce foarte mult efectele termice.
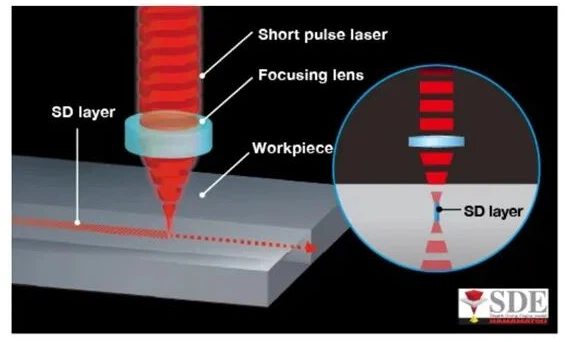
Compania japoneză DISCO a dezvoltat o tehnologie de tăiere cu laser numită Key Amorphe-Black Repetitive Absorption (KABRA). De exemplu, la prelucrarea lingourilor de carbură de siliciu cu diametrul de 6-inchi și grosimea de 20 mm, a crescut de patru ori productivitatea plachetelor cu carbură de siliciu. Procesul KABRA concentrează în esență laserul în interiorul materialului din carbură de siliciu. Prin „absorbție repetitivă amorf-negru”, carbura de siliciu este descompusă în siliciu amorf și carbon amorf, formând un strat care servește ca punct de separare a plachetelor, cunoscut sub numele de stratul amorf negru, care absoarbe mai multă lumină, făcând mult mai ușoară separarea plachetelor.

Tehnologia Cold Split wafer dezvoltată de Siltectra, care a fost achiziționată de Infineon, poate nu numai să divizeze diferite tipuri de lingouri în napolitane, ci și să reducă pierderile de material cu până la 90%, fiecare napolitană pierzând doar 80µm, reducând în cele din urmă costurile totale de producție a dispozitivului cu până la 30%. Tehnologia Cold Split implică doi pași: în primul rând, un laser iradiază lingoul pentru a crea un strat de delaminare, determinând expansiune de volum intern în materialul din carbură de siliciu, care generează tensiuni de tracțiune și formează o micro-fisura foarte îngustă; apoi, o etapă de răcire a polimerului transformă micro-fisura într-o fisură principală, separând în cele din urmă napolitana de lingoul rămas. În 2019, o terță parte a evaluat această tehnologie și a măsurat rugozitatea suprafeței Ra a plachetelor despicate să fie mai mică de 3 µm, cele mai bune rezultate fiind mai mici de 2 µm.

Cubulețele laser modificate dezvoltate de compania chineză Han's Laser este o tehnologie laser utilizată pentru a separa napolitanele semiconductoare în cipuri sau matrițe individuale. Acest proces folosește, de asemenea, un fascicul laser precis pentru a scana și a forma un strat modificat în interiorul plachetei, permițând plachetei să crape de-a lungul traseului de scanare laser sub presiunea aplicată, realizând o separare precisă.
Figura 5. Fluxul procesului de tăiere cu laser modificat
În prezent, producătorii autohtoni stăpânesc tehnologia de tăiere cu carbură de siliciu pe bază de șlam-. Cu toate acestea, tăierea nămolului are pierderi mari de material, eficiență scăzută și poluare severă și este înlocuită treptat de tehnologia de tăiere cu sârmă de diamant. În același timp, zarurile cu laser iese în evidență prin avantajele sale de performanță și eficiență. În comparație cu tehnologiile tradiționale de prelucrare a contactelor mecanice, oferă multe beneficii, inclusiv eficiență ridicată de procesare, linii înguste și densitate mare a tăieturii, făcându-l un concurent puternic pentru a înlocui tăierea cu sârmă de diamant. Deschide o nouă cale pentru aplicarea materialelor semiconductoare de -generație următoare, cum ar fi carbura de siliciu. Odată cu progresul tehnologiei industriale și cu creșterea continuă a dimensiunilor substratului cu carbură de siliciu, tehnologia de tăiere cu carbură de siliciu se va dezvolta rapid, iar tăierea cu laser eficient, de înaltă calitate-va fi o tendință importantă pentru viitoarea tăiere cu carbură de siliciu.









